 тройных твёрдых растворов
тройных твёрдых растворов  а также гетероструктур
а также гетероструктур Полевой транзистор - транзистор ,в
к-ром управление протекающим через него током осуществляется электрич. полем,
перпендикулярным направлению тока. Принцип работы полевого транзистора, сформулированный в
1920-х гг., поясняется на рис. 1. Тонкая пластинка полупроводника (канал) снабжена
двумя омич. электродами (истоком и стоком). Между истоком и стоком расположен
третий электрод - затвор. Напряжение, приложенное между затвором и любым из
двух др. электродов (истоком или стоком),
приводит к появлению в подзатворной области канала электрпч. поля. Влияние этого
поля приводит к изменению кол-ва носителей заряда в канале вблизи затвора и,
как следствие, изменяет сопротивление канала.
Изготовляются полевые транзисторы гл. обр. из Si и GaAs; исследуются
также полевые транзисторы на основе  тройных твёрдых растворов
тройных твёрдых растворов  а также гетероструктур
а также гетероструктур
 и др.
и др.
Если канал полевого транзистора - полупроводник n-тнпа, то ток
в нём переносится электронами, входящими в канал через исток, к к-рому в этом
случае прикладывается отри-цат. потенциал, н выходящими из канала через сток.
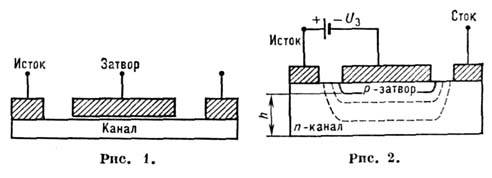
Если канал П.т.- полупроводник р-типа, то к истоку
прикладывается положит, потенциал, а к стоку - отрицательный. При любом типе
проводимости канала ток всегда переносится носителями заряда только одного знака:
либо электронами, либо дырками, поэтому П. т. наз. иногда униполярными транзисторами.
Различают 2 осн. типа П. т. К первому типу относят
П. т., в к-рых затвором служит r - re-переход (П. т. с управляющим
r - h-переходом) или барьер металл - полупроводник (Шоттки
барьер). Ко второму типу относят П. т., в к-рых металлич. электрод затвора
отделён от канала тонким слоем диэлектрика, - П. т. с изолированным затвором.
Идея, лежащая в основе работы П. т. с затвором
в виде p - n-перехода, высказана в нач. 50-х гг. У. Шок-ли (W.
Shockley, США). Она поясняется на рис. 2. Под металлич. электродом затвора П.
т. сформирован р-слой, так что между затвором и любым из двух др, электродов
П. т. существует p - n-переход. Толщина канала d, по к-рому ток
может протекать между истоком и стоком, зависит от напряжения, приложенного
к затвору. Между истоком и затвором прикладывается напряжение смещающее
p - n-переход в запорном направлении (в П. т. с каналом h-типа это
условие соответствует "минусу" на затворе). Тогда под затвором возникает
обеднённый слой (см. p - n-переход ),имеющий очень высокое сопротивление.
Чем больше напряжение
смещающее
p - n-переход в запорном направлении (в П. т. с каналом h-типа это
условие соответствует "минусу" на затворе). Тогда под затвором возникает
обеднённый слой (см. p - n-переход ),имеющий очень высокое сопротивление.
Чем больше напряжение  тем больше толщина обеднённого слоя. В пределах обеднённого слоя ток практически
течь не может. Поэтому увеличение
тем больше толщина обеднённого слоя. В пределах обеднённого слоя ток практически
течь не может. Поэтому увеличение соответствует
сужению канала, по к-рому протекает ток между истоком и стоком. Меняя напряжение
на затворе, можно управлять током в канале. Чем больше
соответствует
сужению канала, по к-рому протекает ток между истоком и стоком. Меняя напряжение
на затворе, можно управлять током в канале. Чем больше тем
толще обеднённый слой и тоньше канал и, следовательно, тем больше его сопротивление
и тем меньше ток в канале. При достаточно большой величине
тем
толще обеднённый слой и тоньше канал и, следовательно, тем больше его сопротивление
и тем меньше ток в канале. При достаточно большой величине обеднённый
слой под затвором может полностью перекрыть канал, и ток в канале обратится
в нуль. Соответствующее напряжение
обеднённый
слой под затвором может полностью перекрыть канал, и ток в канале обратится
в нуль. Соответствующее напряжение  наз. напряжением отсечки. Ширина области объёмного заряда обратносмещён-ного
p - n-перехода
наз. напряжением отсечки. Ширина области объёмного заряда обратносмещён-ного
p - n-перехода  где е - заряд электрона,
где е - заряд электрона, -
концентрация доноров в материале канала, e - диэлектрич. проницаемость
материала,
-
концентрация доноров в материале канала, e - диэлектрич. проницаемость
материала, диэлектрич.
постоянная,
диэлектрич.
постоянная,  контактная
разность потенциалов в p - n-
контактная
разность потенциалов в p - n-
переходе. Очевидно, толщина канала  где
h - геом. толщина канала (рис. 2). Напряжение
отсечки
где
h - геом. толщина канала (рис. 2). Напряжение
отсечки  находится
из условия
находится
из условия 

Принцип работы П. т. с затвором в виде барьера
Шоттки (ПТШ) аналогичен. Разница лишь в том, что обеднённый слой в канале под
затвором создаётся приложением запорного напряжения к контакту металл - полупроводник.
ПТШ и П. т. с управляющим переходом,
как правило, являются П. т. снормально открытым
каналом. Так принято наз. П. т., в к-рых при отсутствии напряжения на затворе
переходом,
как правило, являются П. т. снормально открытым
каналом. Так принято наз. П. т., в к-рых при отсутствии напряжения на затворе канал
открыт и между истоком и стоком возможно протекание тока. В цифровых устройствах для снижения потребляемой мощности применяют также нормально закрытые П.
т. В этих приборах толщина канала h настолько мала, что канал под действием
кон-тактной разности потенциалов
канал
открыт и между истоком и стоком возможно протекание тока. В цифровых устройствах для снижения потребляемой мощности применяют также нормально закрытые П.
т. В этих приборах толщина канала h настолько мала, что канал под действием
кон-тактной разности потенциалов при
нулевом напряжении на затворе полностью обеднён носителями заряда, т. е. канал
практически закрыт. Рабочей областью входных сигналов таких П. т. являются отпирающие
значения
при
нулевом напряжении на затворе полностью обеднён носителями заряда, т. е. канал
практически закрыт. Рабочей областью входных сигналов таких П. т. являются отпирающие
значения
В П. т. с изолиров. затвором между каналом П.
т. и металлич. электродом затвора размещается тонкий слой
диэлектрика (рис. 3, 4). Поэтому такие П. т. наз. МДП-транзисторами (металл
- диэлектрик - полупроводник; см. МДП-структура ).Часто в МДП-тран-зисторе
слоем диэлектрика служит окисел на поверхности полупроводника. В этом случае
П. т. наз. МОП-транзисторами (металл - окисел - полупроводник). Первые МДП-транзисторы
появились в сер. 50-х гг.
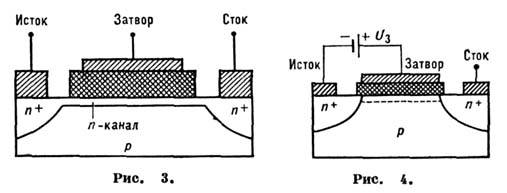
МДП-транзисторы могут быть как с нормально открытым,
так и с нормально закрытым каналами. МДП-транзистор с нормально открытым, встроенным
каналом показан на рис. 3 на примере МДП-транзистора с каналом re-типа. Транзистор
выполнен на подложке р-типа. Сверху подложки методами диффузии, ионной имплантации или эпитаксии формируются проводящий канал re-типа и две глубокие области
для создания омич. контактов в области истока и стока. Область затвора представляет
собой конденсатор, в к-ром одной обкладкой служит металлич. электрод затвора,
а другой - канал П. т. Если между затвором и каналом приложить напряжение, то
в зависимости от его знака канал будет обогащаться или обедняться подвижными
носителями заряда. Соответственно, сопротивление канала будет уменьшаться или
возрастать. В показанной на рис. 3 МДП-структуре с каналом n-типа напряжение,
"плюс" к-рого приложен к затвору, а "минус" - к каналу
(истоку или стоку), вызывает обогащение электронами приповерхностного слоя полупроводника
под затвором. Обратная полярность напряжения на затворе вызывает обеднение канала
электронами аналогично П. т. с управляющим
области
для создания омич. контактов в области истока и стока. Область затвора представляет
собой конденсатор, в к-ром одной обкладкой служит металлич. электрод затвора,
а другой - канал П. т. Если между затвором и каналом приложить напряжение, то
в зависимости от его знака канал будет обогащаться или обедняться подвижными
носителями заряда. Соответственно, сопротивление канала будет уменьшаться или
возрастать. В показанной на рис. 3 МДП-структуре с каналом n-типа напряжение,
"плюс" к-рого приложен к затвору, а "минус" - к каналу
(истоку или стоку), вызывает обогащение электронами приповерхностного слоя полупроводника
под затвором. Обратная полярность напряжения на затворе вызывает обеднение канала
электронами аналогично П. т. с управляющим переходом.
переходом.
Для работы МДП-транзистора принципиально важно,
чтобы поверхность раздела диэлектрик - полупроводник под затвором имела низкую
плотность электронных поверхностных состояний. В противном случае изменение
напряжения на затворе может приводить не к изменению концентрации носителей
в канале, а лишь к перезарядке поверхностных состояний.
МДП-транзистор с индуциров. каналом показан на
рис. 4. Из сравнения рис. 3 и 4 видно, что этот транзистор отличается от МДП-транзистора
со встроенным каналом отсутствием n-слоя под затвором. Если напряжение на затворе
отсутствует то
в МДП-тран-зисторе, показанном на рис. 4, отсутствует и канал (транзистор с
нормально закрытым каналом), а сам транзистор представляет собой два последовательно
включённых
то
в МДП-тран-зисторе, показанном на рис. 4, отсутствует и канал (транзистор с
нормально закрытым каналом), а сам транзистор представляет собой два последовательно
включённых перехода.
При любой полярности напряжения между истоком и стоком один из этих
перехода.
При любой полярности напряжения между истоком и стоком один из этих  переходов оказывается включённым в обратном направлении и ток в цепи исток -
сток практически равен нулю.
переходов оказывается включённым в обратном направлении и ток в цепи исток -
сток практически равен нулю.
Если приложить к затвору напряжение в
такой полярности, как показано на рис. 4, то поле под затвором будет оттеснять
дырки и притягивать в под-затворную область электроны. При достаточно большом
напряжении
в
такой полярности, как показано на рис. 4, то поле под затвором будет оттеснять
дырки и притягивать в под-затворную область электроны. При достаточно большом
напряжении называемом
напряжением отпирания, под затвором происходит инверсия типа проводимости: вблизи
затвора образуется тонкий слой n-типа. Между истоком и стоком возникает проводящий
канал. При дальнейшем увеличении
называемом
напряжением отпирания, под затвором происходит инверсия типа проводимости: вблизи
затвора образуется тонкий слой n-типа. Между истоком и стоком возникает проводящий
канал. При дальнейшем увеличении возрастает
концентрация электронов в канале и сопротивление его уменьшается.
возрастает
концентрация электронов в канале и сопротивление его уменьшается.
Осн. параметры П. т. Для П. т. характерно очень
высокое входное сопротивление по пост, току
Действительно, входной сигнал в П. т. подаётся
на затвор, сопротивление к-рого в П. т. с управляющим  переходом и ПТШ определяется сопротивлением обратно смещённого
переходом и ПТШ определяется сопротивлением обратно смещённого  перехода
или сопротивлением барьера Шоттки, а в МДП-транзисторе - сопротивлением слоя
диэлектрика. Величина
перехода
или сопротивлением барьера Шоттки, а в МДП-транзисторе - сопротивлением слоя
диэлектрика. Величина в
П. т. обычно превосходит 106 Ом, в нек-рых конструкциях достигает
1014 Ом. Входное сопротивление по перем. току практически определяется
ёмкостью затвора
в
П. т. обычно превосходит 106 Ом, в нек-рых конструкциях достигает
1014 Ом. Входное сопротивление по перем. току практически определяется
ёмкостью затвора В сверхвысокочастотных П. т. величина
В сверхвысокочастотных П. т. величина  пФ, в мощных низкочастотных П. т. величина
пФ, в мощных низкочастотных П. т. величина пФ.
пФ.
Усилит, свойства П. т. характеризуются крутизной
вольт-амперной характеристики 5, определяемой как отношение изменения тока между
истоком и стоком (тока стока) к
изменению напряжения на затворе
к
изменению напряжения на затворе  при пост, напряжении на стоке:
при пост, напряжении на стоке:

При неизменной структуре прибора крутизна растёт
прямо пропорционально ширине затвора В (рис. 5). Поэтому при сравнении
усилит, свойств разл. типов П. т. используется понятие уд. крутизны (отношения
крутизны к ширине затвора В). Крутизна П. т. измеряется
в сименсах, уд. крутизна - в сименсах/мм. В серийных П. т.
(отношения
крутизны к ширине затвора В). Крутизна П. т. измеряется
в сименсах, уд. крутизна - в сименсах/мм. В серийных П. т. См/мм.
В лаб. разработках достигнуты значения
См/мм.
В лаб. разработках достигнуты значения при
300 К и
при
300 К и  при 77 К.
при 77 К.
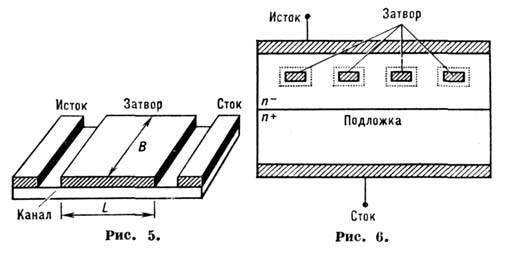
П. т. относятся к малошумящим приборам. Типичное
значение коэф. шума (см. Шумовая температура)серийных П. т. дБ. Предельные ВЧ-свойства П. т. определяются
временем пролёта носителей под затвором tпр вдоль канала.
Макс, рабочая частота П. т. может быть оценена, как
дБ. Предельные ВЧ-свойства П. т. определяются
временем пролёта носителей под затвором tпр вдоль канала.
Макс, рабочая частота П. т. может быть оценена, как где L - длина затвора (рис. 5). Величина
L в серийных П. т. составляет 0,5-10 мкм. В лаб. условиях широко исследуются
приборы с
где L - длина затвора (рис. 5). Величина
L в серийных П. т. составляет 0,5-10 мкм. В лаб. условиях широко исследуются
приборы с мкм.
Величина uмакс в кремниевых приборах не превосходит дрейфовой
скорости насыщения
мкм.
Величина uмакс в кремниевых приборах не превосходит дрейфовой
скорости насыщения см/с
(см. Лавинно-пролётный диод ).В П. т. на основе соединений
см/с
(см. Лавинно-пролётный диод ).В П. т. на основе соединений при
при
 мкм важную роль играют т. н. баллис-тич. эффекты (движение носителей заряда
без столкновений на длине канала), за счёт к-рых величина
мкм важную роль играют т. н. баллис-тич. эффекты (движение носителей заряда
без столкновений на длине канала), за счёт к-рых величина  возрастает до
возрастает до Предельная
частота генерации П. т. превосходит 200
ГГц. Предельно малое время переключения
Предельная
частота генерации П. т. превосходит 200
ГГц. Предельно малое время переключения
Осн. разновидности П. т. По областям применения
все П. т. можно условно разбить на 4 осн. группы: П. т. для цифровых устройств
и интегральных схем (ЦУ и ИС), П. т. общего применения, сверхвысокочастотные
П. т. и мощные П. т.
П. т., предназначенные для работы в ЦУ и ИС,
должны обладать малыми габаритами, высокой скоростью переключения и мин. энергией
переключения. Серийные П. т. для ЦУ и ИС в наст, время изготовляются в осн.
из Si и характеризуются следующими параметрами: длина затвора мкм,
время переключения
мкм,
время переключения нс,
энергия переключения
нс,
энергия переключения пДж.
Лучшие результаты получены с использованием
П. т. на основе гетерострук-тур с селективным легированием (ГСЛ) [3, 4]. В ГСЛ-транзисторах,
называемых также транзисторами с высокой подвижностью электронов (ВПЭТ), используются
свойства двумерного электронного газа, образующегося в нек-рых гетероструктурах
на границе узкозонного и широкозонного слоев гетеропары. С использованием гетеропары
пДж.
Лучшие результаты получены с использованием
П. т. на основе гетерострук-тур с селективным легированием (ГСЛ) [3, 4]. В ГСЛ-транзисторах,
называемых также транзисторами с высокой подвижностью электронов (ВПЭТ), используются
свойства двумерного электронного газа, образующегося в нек-рых гетероструктурах
на границе узкозонного и широкозонного слоев гетеропары. С использованием гетеропары
 получены
ГСЛ-транзисторы с временем переключения 5 пс и энергией переключения
получены
ГСЛ-транзисторы с временем переключения 5 пс и энергией переключения Дж.
Исследуются также ГСЛ-транзисторы с использованием др. гетеропар на основе соединений
Дж.
Исследуются также ГСЛ-транзисторы с использованием др. гетеропар на основе соединений
Осн. требование к сверхвысокочастотным П. т.
состоит в достижении макс, мощности или коэф. усиления на предельно высокой
частоте. Продвижение в область высоких частот требует уменьшения длины затвора
и макс, использования баллистич. эффектов для достижения высокой скорости носителей.
Для изготовления сверхвысокочастотных П. т. в наст, время используется в осн. в к-ром баллистич. превышение скорости над максимально возможным равновесным
значением выражено значительно сильнее, чем в
в к-ром баллистич. превышение скорости над максимально возможным равновесным
значением выражено значительно сильнее, чем в Серийные
СВЧ П. т. работают на частотах до
Серийные
СВЧ П. т. работают на частотах до Лаб.
разработки проводятся на частотах 90-110 ГГц. Предельная частота генерации (230
ГГц) получена в ГСЛ-транзисторах на основе
Лаб.
разработки проводятся на частотах 90-110 ГГц. Предельная частота генерации (230
ГГц) получена в ГСЛ-транзисторах на основе изготовленных
с помощью молекулярно-пучковой эпитаксии.
изготовленных
с помощью молекулярно-пучковой эпитаксии.
Мощные П. т. работают при напряжении в цепи канала В
и коммутируемом токе
В
и коммутируемом токе Т.
к. мощность на единицу рабочей площади структуры принципиально ограничена необходимостью
отводить тепло, мощные П. т. имеют большую общую длину электродов. Часто используется
встречно-штыревая система электродов [2]. Мощные П. т. изготовляются на основе
Т.
к. мощность на единицу рабочей площади структуры принципиально ограничена необходимостью
отводить тепло, мощные П. т. имеют большую общую длину электродов. Часто используется
встречно-штыревая система электродов [2]. Мощные П. т. изготовляются на основе и
и  Характерные
рабочие частоты мощных П. т. достигают величин
Характерные
рабочие частоты мощных П. т. достигают величин  МГц.
МГц.
Новые разновидности П. т. Транзисторы с проницаемой
базой (ТПБ) предложены в 1979 и, по оценкам, способны, в принципе, повысить
рабочую частоту П. т. до 1012 Гц (1 ТГц). Носители заряда в канале
ТПБ движутся не вдоль поверхности полупроводниковой плёнки, а перпендикулярно
ей. Длина канала, и следовательно время пролёта носителей, в ТПБ могут быть
значительно уменьшены в сравнении с планар-ным П. т. При планарной конструкции
мин. размер затвора L определяется возможностями рентг. или электронно-лучевой
микролитографии:  мкм
мкм
(1000 ).
Предельно малая величина L в ТПБ определяется толщиной плёнки, к-рая
может быть получена в совр. установке молекулярно-пучковой эпитаксии, и составляет
неск. атомных слоев.
).
Предельно малая величина L в ТПБ определяется толщиной плёнки, к-рая
может быть получена в совр. установке молекулярно-пучковой эпитаксии, и составляет
неск. атомных слоев.
Электроны в ТПБ (рис. 6) движутся от истока к
стоку в направлении, перпендикулярном поверхности плёнки. Затвором служит металлич.
сетка, "погружённая" в толщу полупроводниковой структуры ТПБ. По
принципу действия ТПБ аналогичен ПТШ. Между металлич. сеткой и полупроводником
возникает барьер Шоттки. Толщина обеднённой области вблизи проводников сетки
определяется напряжением на затворе. Если толщина обеднённой области меньше
расстояния между проводниками сетки, канал открыт и электроны свободно движутся
к стоку. При достаточно большом напряжении обеднённые области
перекрываются - канал закрыт. Осн. проблема создания ТПБ состоит в получении
качеств, границы раздела металл - полупроводник. ТПБ имеет большое сходство
с электронной лампой, в к-рой управляющим электродом является металлич. сетка.
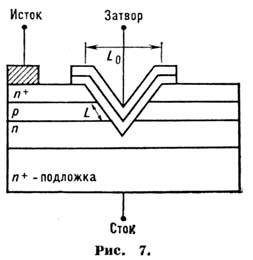
Др. разновидностью П. т., в к-ром достигается
уменьшение длины канала, является П. т. с  канавкой
(рис. 7), к-рый по принципу действия представляет собой МДП-тран-зистор с индуциров.
каналом. Однако длина канала в такой структуре определяется не размером канавки
в её верх, части
канавкой
(рис. 7), к-рый по принципу действия представляет собой МДП-тран-зистор с индуциров.
каналом. Однако длина канала в такой структуре определяется не размером канавки
в её верх, части (рис.
7), а толщиной
(рис.
7), а толщиной слоя
и углом между склонами канавки и слоями П. т. Длина затвора в такой конструкции
может быть в неск. раз меньшей, чем в планарном П. т. Изготовление П. т. с V-канавкой
основано на анизотропии травления Si и GaAs при определ. ориентации поверхности
полупроводниковой структуры.
слоя
и углом между склонами канавки и слоями П. т. Длина затвора в такой конструкции
может быть в неск. раз меньшей, чем в планарном П. т. Изготовление П. т. с V-канавкой
основано на анизотропии травления Si и GaAs при определ. ориентации поверхности
полупроводниковой структуры.
Нек-рые др. типы быстродействующих транзисторов рассмотрены в [3, 4].

М. Е, Левинштейн, Г. С. Симин
Понятие же "физического вакуума" в релятивистской квантовой теории поля подразумевает, что во-первых, он не имеет физической природы, в нем лишь виртуальные частицы у которых нет физической системы отсчета, это "фантомы", во-вторых, "физический вакуум" - это наинизшее состояние поля, "нуль-точка", что противоречит реальным фактам, так как, на самом деле, вся энергия материи содержится в эфире и нет иной энергии и иного носителя полей и вещества кроме самого эфира.
В отличие от лукавого понятия "физический вакуум", как бы совместимого с релятивизмом, понятие "эфир" подразумевает наличие базового уровня всей физической материи, имеющего как собственную систему отсчета (обнаруживаемую экспериментально, например, через фоновое космичекое излучение, - тепловое излучение самого эфира), так и являющимся носителем 100% энергии вселенной, а не "нуль-точкой" или "остаточными", "нулевыми колебаниями пространства". Подробнее читайте в FAQ по эфирной физике.
|
|